Glass Substrate Integrated Micro-Thermoelectric Coolers: Revolutionizing the Thermal Management of Optoelectronic Co-packaging
Optoelectronic co-packaging is a technical field that combines optics and electronics. Photonic devices utilize light to transmit information, perform calculations, or conduct high-precision measurements. One of the main advantages of photons is their ability to process a large amount of data at a very high speed. This makes them ideal for telecommunications and information processing applications that require the fast and efficient transmission of large amounts of data. Photonic devices also have high energy efficiency and low losses, which is a significant advantage in applications where low energy consumption is emphasized.

Glass Substrate Integrated Micro-Thermoelectric Coolers: Revolutionizing the Thermal Management of Optoelectronic Co-packaging
1. Technical Characteristics and Advantages of Optoelectronic Co-packaging
Optoelectronic co-packaging is a technical field that combines optics and electronics. Photonic devices utilize light to transmit information, perform calculations, or conduct high-precision measurements. One of the main advantages of photons is their ability to process a large amount of data at a very high speed. This makes them ideal for telecommunications and information processing applications that require the fast and efficient transmission of large amounts of data. Photonic devices also have high energy efficiency and low losses, which is a significant advantage in applications where low energy consumption is emphasized.
2. The Crucial Role of Thermal Management in Optoelectronic Co-packaging
In high-performance applications, thermal crosstalk between electronic and photonic chips, as well as environmental temperature fluctuations, can have a negative impact on the performance of photonic chips. Therefore, thermal management plays a vital role in optoelectronic co-packaging.
3. Advantages and Challenges of Glass Substrate in Optoelectronic Co-packaging
Glass is considered a suitable platform for next-generation optoelectronic co-packaging due to its low thermal conductivity, which can minimize unnecessary heat transfer between electronic and photonic components. This property of glass helps to achieve proper thermal isolation between the chip and the chip-fiber interface. However, this also brings another challenge in thermal management – the heat generated by electronic chips must be dissipated within the glass package to eliminate its impact on the temperature-sensitive photonic chips.
4. Innovative Thermal Management Strategy: Integration of Micro-Thermoelectric Coolers
The general approach is to add through-glass vias (TGVs) in the glass substrate to achieve effective heat dissipation of electronic chips. Recently, Parnika Gupta and others from University College Cork in Ireland have proposed another innovative thermal management strategy, which is to integrate micro-thermoelectric coolers (micro-TECs) at the bottom of the chip to provide active temperature control.
5. The Principle and Advantages of SimTEC Technology
This technology, known as “Substrate Integrated Micro-Thermoelectric Coolers (SimTEC)” by researchers, uses glass through-vias (TGVs) filled with electroplated copper and thermoelectric materials as the pillars of the thermoelectric cooler (TEC). It can not only conduct targeted and precise thermal management of photonic chips, enhance the thermal connectivity with the surface of the photonic chip (bonded face down to the substrate), but also maintain the compact form factor of the glass package. By transitioning from bonding based on micro-bumps and underfill to copper-copper (Cu-Cu) hybrid bonding, the thermal resistance at the interface between the chip surface and the cold-side TEC can be further reduced.
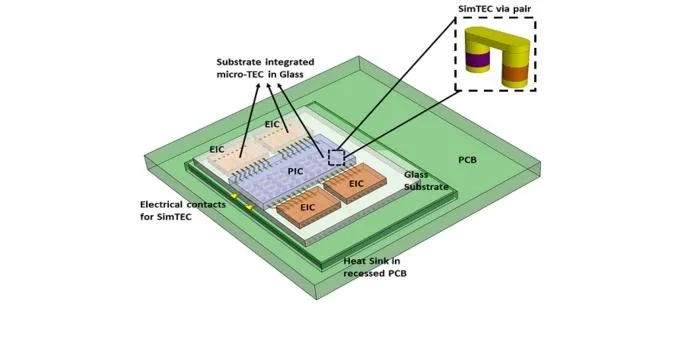
Figure: Schematic diagram of the SimTEC architecture in the glass substrate. The SimTEC through-vias are located in the central area of the electronic chip (EIC) and the photonic chip (PIC). The peripheral I/O of the chip is dedicated to the electrical connections in the optoelectronic co-packaging.
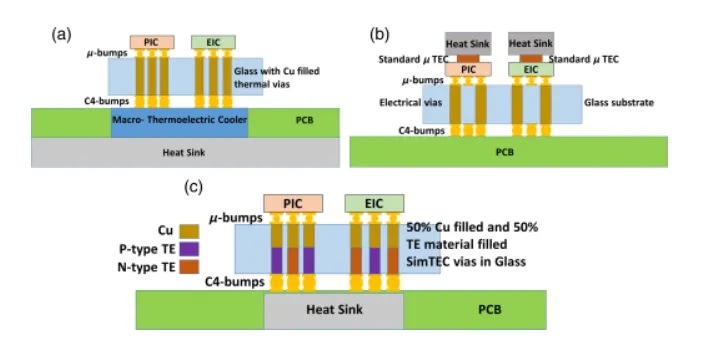
Figure: Schematic diagrams show different methods of integrating thermoelectric coolers (TECs) in optoelectronic co-packaging, where photonic integrated chips (PICs) and electronic integrated chips (EICs) are co-packaged on a glass substrate: (a) Macro-thermoelectric cooler (Macro-TEC), (b) Micro-thermoelectric cooler (μ-TEC), and (c) Substrate integrated micro-thermoelectric cooler (SimTEC).
Customized Heat Sinks: Personalized Solutions for Thermal Management in Optoelectronic Co-packaging
In the practice of thermal management for optoelectronic co-packaging, different application scenarios have unique requirements for heat dissipation, which also highlights the importance of customized heat sinks. Customized heat sinks can provide precise thermal management solutions according to specific chip layouts, power levels, and space limitations.
Diverse Customization Options to Meet Multiple Needs
- Liquid cold plate: For areas with high heat flux density chips, customized liquid cold plate solutions can quickly remove heat and achieve efficient heat dissipation by optimizing the flow path and velocity of the cooling liquid. Its flexible pipeline design and material selection can adapt to different heat dissipation intensities and environmental requirements.
- skived heat sink: It can be customized to have a heat dissipation structure with higher heat dissipation fin density and appropriate height according to the shape of the equipment and heat dissipation requirements, maximizing the heat exchange area within a limited space. Whether it is single-sided skiving or special-shaped tooth design, it can provide stable and reliable heat dissipation support for the equipment.
- Heat pipe heat sink: For some applications that are sensitive to weight and space, the customized design of heat pipe heat sinks can ensure the heat dissipation effect while reducing the overall weight, improving the portability and integration of the equipment. By adjusting the number, length, and layout of the heat pipes, the heat dissipation needs of the equipment can be precisely matched.
Choose Us and Start a Professional Customization Journey
No matter what complex thermal management challenges you face, we can tailor the most suitable heat sink solutions for you with our professional technical team and rich industry experience. From requirements analysis, scheme design to manufacturing, we control the quality throughout the process to ensure reliable thermal management for your equipment. Contact us now to start the journey of customized heat sinks. Let professional thermal management solutions empower your products and help you stand out in the market competition!


